随着科技的进步和国民经济的不断发展,人们开始越来越注重电子产品的轻量化、便携化,电子产品的体积的缩小,工作效率加快,这些因素导致其产生的热量高于以往。由于热量产生过多,会使产品的使用寿命大大降低,所以电子封装材料则成为电子产品热管理的关键。
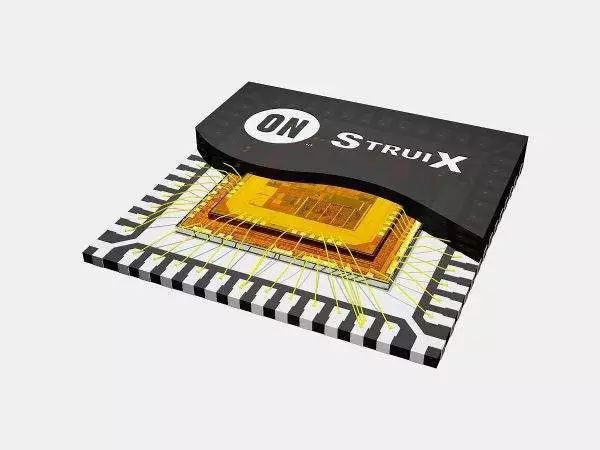
什么是电子封装?

电子封装就是安装集成电路内置芯片外用的管壳,起着安放固定密封,保护集成电路内置芯片,增强环境适应的能力,并且集成电路芯片上的铆点也就是接点,是焊接到封装管壳的引脚上的。
环氧树脂有哪些特点?
环氧树脂 (EP) 是一类具有良好耐腐蚀性、绝缘性及高强度的热固性高分子合成材料,其同时具有耐化学药品性和良好的尺寸稳定性,粘结强度高、综合性能优异、价格便宜,因而得到广泛应用。但 EP 的热导率为 0.2 W/(m · K) 左右,一般需要加入无机填料以提高导热性能。无机填料的主要作用是降低热膨胀系数、吸水率、成型收缩率和生产成本,还可以起到增强作用,提高可靠性。

图1:环氧树脂常见无机填料及主要作用
导热机理
聚合物复合材料主要依靠晶格振动进行导热,也就是依靠声子来进行传热。
EP 是一种非晶聚合物,主要依靠声子传热,由于其巨大的分子量以及分子量的多分散性,分子大小不等和分子链无规缠结,声子散射严重,使 EP 的导热性能不佳,电子封装用以填充型导热 EP 为主。目前填充型导热高分子材料导热机理的理论主要有三种:导热通路理论、逾渗理论和热弹性系数理论。
常用EP导热填料介绍
No.1
无机陶瓷填料之一—AIN
AlN 具有高导热系数并且绝缘性能优良,导热系数可达200~300 W/(m · K),热稳定性好,室温强度高,热膨胀系数为 4.5×10 –6 /℃,AlN 还是优良的电绝缘体,介电性能优良,作为填料可以很大程度地提高基体材料的热导率。
赵广辉等制备的 EP/AlN 导热复合材料,AlN 含量为 30% 时,热导率达到 0.75 W/(m · K),约为 EP 的 4 倍。AlN 虽然有较高的热导率但是价格昂贵,限制了 AlN 在导热材料中的应用。
No.1
无机陶瓷填料之二——BN
BN 不仅具有良好的导热性还具有抗腐蚀和耐热性,比如氮化硼纳米管 (BNNT)具有良好的电绝缘性、非常好的化学、热稳定性和力学性能,BNNT 还具有沿轴向为 600 W/(m · K) 的高热导率,易于在聚合物基体中形成导热通路,C. Y. Zhi 等制备 EP/BNNT 复合材料,BNNT 质量分数为 5% 时 EP 的热导率提高了 69%。BN 作为聚合物导热填料有非常好的应用前景。
No.2
碳材料之一——石墨烯
石墨烯具有非常好的热传导性能同时具有良好的导电性,纯的无缺陷的单层石墨烯的热导率高达 5 000 W/(m · K),是目前为止热导率最高的碳材料,是一种极好的导热候选材料。
同时石墨烯有非常高的比表面积,但是石墨烯加入到聚合物基体中造成了更多界面的产生,因此热量很难穿过石墨烯与聚合物基体之间的界面。石墨烯与聚合物之间的界面热阻成为影响复合材料热导率的主要因素。所以对石墨烯进行表面改性是提高复合材料热导率,降低界面热阻的有效方法。
No.2
碳材料之二——碳纳米管
碳纳米管 (CNT) 具有良好的导热性能,由于其具有高长径比,垂直方向的传热性能较差,沿长度方向传热性能良好,通过合适取向可以制备各向异性的导热材料,在基体中加入少量的 CNT 就可能显著改善复合材料的导热性能。
有学者想要对CNT进行改性,但是表面改性会造成 CNT 结构的破坏,不利于复合材料性能提高,在 CNT 与基体之间构建化学键以期提高复合材料的热导率的方法不利于声子传导,亦不能有效地改善材料的导热性。
前沿进展
石墨烯具有超高的比表面积,易于搭建有效地孔道,增大导热率。目前制备石墨烯三维结构的方法主要有化学气相沉积法和冰模板法,但这些方法因为制备成本高昂而且较难获得较高含量的石墨烯,因此此种工艺一直存在调整。
据报道,近期以石墨烯为填料的导热环氧复合材料出现了巨大突破。中科院宁波材料研究所碳素材料团队开发了使用商用聚氨酯泡沫为原料,在其表面包覆石墨烯纳米材料的方法,并采用快速加去除聚氨酯的方法,从而得到三维石墨烯材料。

该法还表明在石墨烯抽滤过程中引入微米尺度的氧化铝,可以使得石墨烯片区水平方向部分转变为纵向方向得到具有类似豌豆荚的结构这类仿豌豆荚结构的二元石墨烯氧化石墨烯氧化铝填料。可有效增强聚合物材料的导热性能。该方法制备的环氧复合材料纵向和横向的导。据悉,开发的热导热环氧复合材料。有望取代传统的聚合物材料,解决目前高度集成的电子设备的散热问题。
该法还表明在石墨烯抽滤过程中引入微米尺度的氧化铝,可以使得石墨烯片区水平方向部分转变为纵向方向,得到具有类似“豌豆荚”的结构。
这类结构增大了空间比表面积,可有效增强聚合物材料的导热性能。该方法制备的环氧复合材料纵向和横向的导。据悉,此类开发的导热环氧复合材料,有望取代传统的聚合物材料,解决目前高度集成的电子设备的散热问题。该篇文章已经发表在材料化工领域的权威期刊上。

参考文献
[1] Zhiduo Liu,Yapeng et al.Graphene foam-embedded epoxy composites with significant thermal conductivity enhancement[J],Nanoscale,2019,11:17600-17606.
[2] 谢宇宁,雷华,石倩.电子封装用导热环氧树脂基复合材料的研究进展[J],工程塑料应用,2018,46(12):143-147.
[3] 李 冰, 张晓伟.环氧树脂基导热复合材料的研究进展[J],中国胶粘剂,2008.17(1):60-62.
[4] 王艺颖,高导热环氧树脂复合材料的制备与性能研究[D],哈尔滨,哈尔滨理工大学(硕士学位论文),2019,3.
编辑:武龙
校对:艾玉露,梁丰,马舒扬,罗浚林